Ball grid array (BGA): Ang proseso ng pagpapalit ng lahat ng solder ball sa ball grid array ng chip ay tinatawag na BGA rebound. Ang mga pakete ng BGA ay naging napakasikat sa printed circuit board (PCB) na disenyo at industriya ng pagmamanupaktura. Nakakatulong ang mga package na ito na bawasan ang laki ng isang PCB at pahusayin ang functionality nito. Maaaring mapaglabanan ng BGA ang presyon ng pagpapababa ng laki ng produkto, at bihira silang nangangailangan ng pagpapanatili at pagkumpuni. Paano inaayos ang mga pakete ng BGA, at anong mga hakbang ang nire-rework ng BGA? Pangunahing inilalarawan ng artikulong ito ang "BGA" IC desoldering at BGA reballing na proseso, at ang mga bagay na nangangailangan ng pansin sa proseso ng pagkumpuni.

I. Ang mga Usapin ay Kailangang Pansin sa Proseso ng Pag-aayos ng BGA Chip
- Ang mga operator ay dapat magsuot ng electrostatic bracelets.
- Dapat ayusin nang maaga ang daloy ng hangin at presyon ng hot air gun bago i-desoldering ang BGA
- Ang temperatura ng hot air gun ay dapat na maayos na itakda nang maaga (karaniwang kinokontrol sa 280~320 ℃) upang maiwasan ang chip na masira ng sobrang mataas na temperatura sa proseso ng desoldering. Hindi nito dapat ayusin muli ang temperatura sa panahon ng desoldering.
- Kapag na-desoldering ang BGA, dahan-dahang hawakan ang BGA gamit ang mga sipit upang kumpirmahin kung natutunaw ang panghinang sa pad upang maiwasang masira ang BGA pad sa circuit board.
- Upang maiwasan ang pangalawang paghihinang ng bola, ang oryentasyong minarkahan sa PCBA, ay dapat bigyang pansin kapag nag-aayos ng BGA.
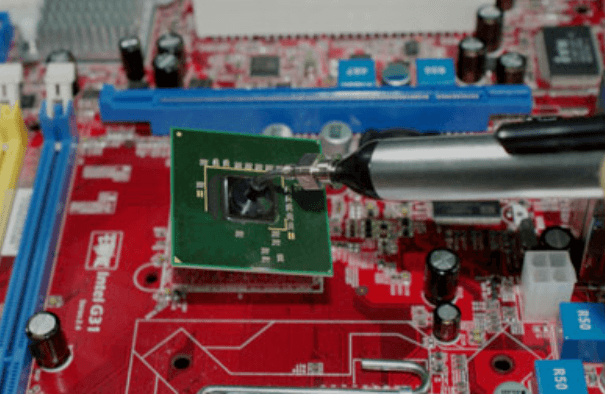
II.Mga pangunahing kagamitan at kasangkapan na gagamitin sa pagkukumpuni ng BGA
- Matalinong hot air gun. (para sa pag-desoldering ng BGA)
- Anti-static maintenance platform at electrostatic bracelet. (kailangan ng electrostatic na kapaligiran)
- Anti-static na kagamitan sa paglilinis. (para sa paglilinis ng BGA)
- BGA repair platform. (para sa paghihinang ng BGA)
- High temperature box (ginagamit para sa pagbe-bake ng PCBA board)
- Mga pantulong na kagamitan: vacuum suction pen, magnifying glass (microscope)

III.Paghahanda ng PCB board baking at mga kaugnay na kinakailangan bago ayusin
(1) Ayon sa iba't ibang oras ng pagkakalantad, ang PCBA board ay binibigyan ng iba't ibang mga kinakailangan sa pagluluto.
(2) Oras ng pagluluto, pagluluto ayon sa mga sumusunod na probisyon:
Oras ng pagkakalantad ≤2 buwan, higit sa 2 buwan
Oras ng pagluluto ng 10 oras, 20 oras
Temperatura ng pagbe-bake 105±5℃, 105±5℃
(3) Sa harap ng baking board, alisin ang mga sangkap na sensitibo sa temperatura pagkatapos ng pagluluto, tulad ng optical fiber, plastic, atbp.; Kung hindi, masisira nito ang mga sangkap na ito dahil sa mataas na temperatura.
(4) Para sa lahat ng board, dapat kumpletuhin ang pag-aayos ng BGA sa loob ng 10 oras pagkatapos kunin ang mga board pagkatapos i-bake.
(5) Ang PCBA board na hindi makakumpleto ng BGA repair work sa loob ng 10 oras ay dapat ilagay sa isang drying oven para sa pangangalaga. Kung hindi, madaling humantong sa malagkit na likod, at ang basa na PCBA ay madaling maging sanhi ng PCBA drum kapag naghihinang.
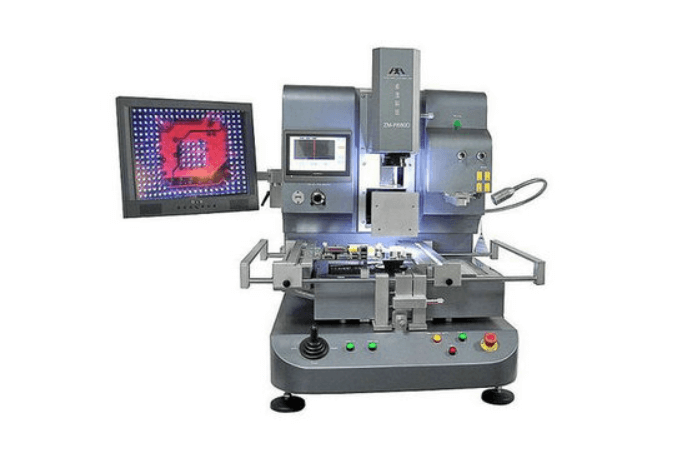
VI. Mga hakbang sa pagpapatakbo ng pag-desoldering at pagrerebelde ng BGA chip
Paghahanda bago ang pag-desoldering ng BGA
Ang parameter state ng hot air gun ay nakatakda sa mga sumusunod: ang temperatura ay 280 ℃~320 ℃; oras ng desoldering: 35-55 segundo; Mga parameter ng daloy ng hangin: 6 na antas; Sa wakas, ang PCBA ay inilalagay sa anti-static na platform ng pagpapanatili at naayos.
BGA desoldering
Tandaan na ang oryentasyon at posisyon ng chip bago mag-desoldering, tulad ng walang silkscreen sa PCBA, na may marker pen kasama ng all round draw, o sa tabi ng pag-inject ng maliit na flux sa ibaba ng BGA, piliin ang naaangkop na laki ng BGA , BGA paghihinang nguso ng gripo ay naka-install sa hot air gun, ay hawakan ang vertical alignment BGA, ngunit bigyang-pansin ang nguso ng gripo ay dapat mag-iwan ng mga bahagi ca. 4 mm, simulan ang heat gun, Ang hot air gun ay awtomatikong mag-desolder ayon sa mga preset na parameter. Pagkatapos ng dulo ng desolder, alisin ang mga bahagi ng BGA gamit ang isang suction pen pagkalipas ng 2 segundo. Pagkatapos lansagin ang mga device, tingnan kung ang mga solder pad ng mga natanggal na makina ay nahuhulog at kung ang mga bakas ay scratched, peeled off, o nasira, atbp. If ay magbibigay ng abnormal na feedback at paggamot sa oras.
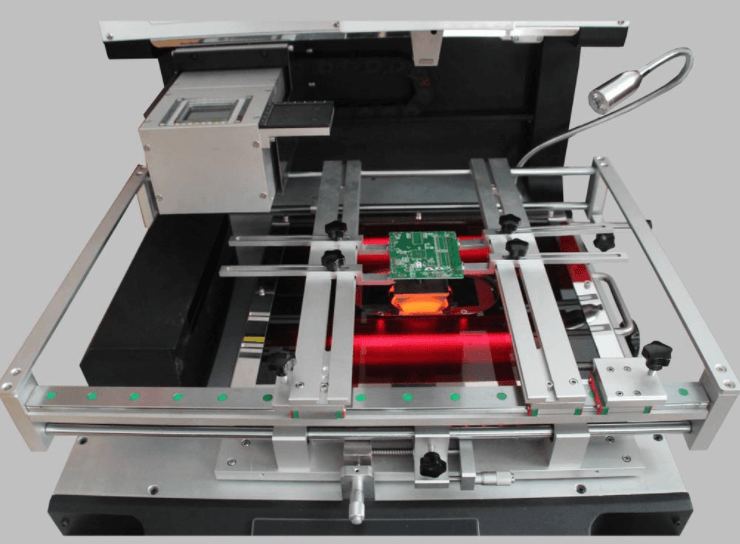
Paglilinis ng BGA at PCB
(1) ilagay ang board sa work table at gumamit ng soldering iron na sumipsip ng mga redundant residues mula sa pad, flat pad, paglilinis kapag inilagay ang tin absorption line sa solder pad, isang kamay para iangat ang suction tin line, ilagay ang iron absorption tin line, dahan-dahang pindutin ng kamay ang bakal, ang natitirang paghihinang PCBA o sa BGA solder ay natunaw at ang adsorption upang sumipsip ng linya ng lata, ang linya ng pagsipsip ng lata ay ililipat sa kabilang lugar, Upang masipsip ang natitirang bahagi ng panghinang, tandaan: huwag pilitin ang panghinang pad upang i-drag , upang maiwasan ang pinsala sa solder pad.
(2) Pagkatapos linisin ang mga pad, gamitin ang washing water upang linisin ang mga PCBA pad. Kung ang virtual na paghihinang CPU ay kailangang itanim muli ang bola, gamitin ang ultrasonic cleaner (na may isang anti-static na aparato) upang i-load ang washing water, at ang tinanggal na BGA ay dapat linisin at muling itanim ang bola para sa paghihinang.
Tandaan: Para sa paglilinis ng solder pad ng mga lead-free na device, ang temperatura ng soldering iron ay kailangang < measured value >340+/-40℃; Para sa paglilinis ng CBGA at CCGA pads, ang temperatura ng soldering iron ay kailangang < measured value >370+/-30 ℃; may mga tiyak na pagkakaiba sa bawat paghihinang na bakal (tulad ng mababang temperatura ng paghihinang), mangyaring isulong, at ang kinauukulan ay gagawa ng mga pagsasaayos ayon sa aktwal na sitwasyon. Kung walang pagsasaayos na ginawa, dapat mahigpit na ipatupad ang mga kinakailangan sa itaas.
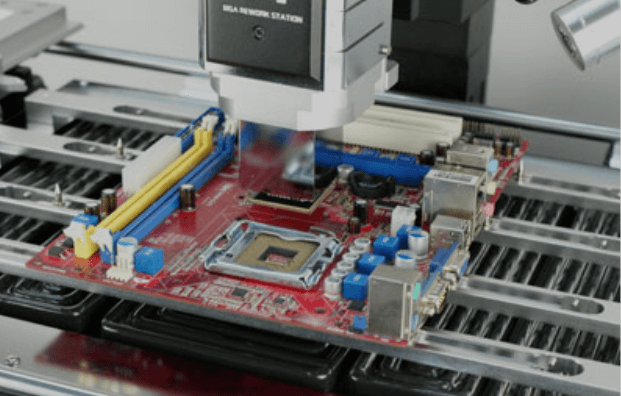
BGA chip reballing
Ang pagtatanim ng lata ng BGA chip ay dapat gawin ng laser-punched stencil na may single-side horn mesh. Ang kapal ng stencil ay dapat na 2mm makapal, at ang butas na dingding ay dapat na makinis at maayos. Ang ilalim ng butas ng sungay (ang mukha na kumontak sa BGA) ay dapat na 10μm~15μm na mas malaki kaysa sa itaas (pag-scrape ng lata sa lugar). Gamit ang function ng pagtatanim ng lata sa talahanayan ng pagpapanatili ng BGA sa itaas — fixture at stencil, hanapin muna ang kaukulang concave na posisyon sa positioning fixture, ayusin ang BGA sa positioning fixture, ilagay ang stencil na may tumpak na positioning square at round hole sa positioning fixture, at pagkatapos ay pindutin ang stencil sa kabit kasama ang accessory nito na magnetic press block. Ang tool ay may tatlong precision positioning device (BGA→ fixture → stencil), na madaling at tumpak na maiayon ang stencil mesh sa maliit na solder pad ng BGA component.
Ang isang maliit na scraper ay isang maliit na halaga ng makapal na lata slurry na nasimot sa stencil mesh. Kapag ang lahat ng mesh ay puno na, mula sa isang dulo ng stencil ay dahan-dahang itataas, BGA chip, isang maliit na lata pile, muli gamit ang isang hot air gun upang painitin ito, ang BGA lata pile sa isang pare-parehong hanay ng mga lata bola maaari maging. Kung walang bola ng lata sa mga indibidwal na pad, maaaring pinindot muli ang isang stencil para sa lokal na pagpuno ng lata. Hindi ito maaaring painitin kasama ng stencil dahil nakakaapekto ito sa reballing at magiging tumpak na stencil thermal deformation at pinsala.
Paghihinang ng BGA chip
Isawsaw ang isang maliit na halaga ng siksik na pagkilos ng bagay sa BGA tin balls at PCBA pads, kunin ang orihinal na marka at ilagay ang BGA. Ang BGA ay dapat na nakadikit at nakaposisyon upang maiwasan ito na tangayin ng mainit na hangin. Gayunpaman, dapat tandaan na ang labis na pagkilos ng bagay ay hindi dapat ilagay. Kung hindi, ang labis na mga bula ng rosin ay magiging sanhi ng paglilipat ng chip kapag umiinit. Ang PCBA board ay naayos din sa BGA rework platform at dapat ilagay sa antas, palitan ang angkop na nozzle, nozzle sa BGA chip at iniwan ang 4 mm, piliin ang BGA sa rework stations primary set temperature curve, mag-click sa screen ng awtomatikong paghihinang (tandaan : hindi maglalapat ng presyon sa proseso ng paghihinang ng BGA, madaling magdulot ng maikling circuit sa pagitan ng bola ng lata sa ilalim ng.)
Sa pagtunaw ng BGA tin ball at pagbuo ng PCBA solder pad soldering, at sa pamamagitan ng surface tension ng tin ball, ang chip ay awtomatikong isentro kahit na may deviation mula sa motherboard. Kapag ang BGA repair table ay pinainit, ang BGA soldering operation ay makukumpleto sa oras na ito. Gayunpaman, dapat tandaan na ang talahanayan ng pag-aayos ng BGA ay gagawa ng tunog ng alarma pagkatapos ng pag-init. Sa oras na ito, huwag ilipat ang BGA repair table at PCBA board dahil ang BGA repair table at PCBA board ay nasa mataas na temperatura at unsolidified state. Dapat itong maghintay ng 40 segundo bago ang talahanayan ng pag-aayos ng BGA, at lumalamig ang PCBA.
Inspeksyon ng BGA paghihinang at paglilinis ng PCBA board
1. Pagkatapos makumpleto ang paghihinang, ang mga bahagi ng BGA at PCBA ay dapat linisin sa pamamagitan ng paghuhugas ng tubig sa plato upang maalis ang labis na flux at posibleng mga scrap ng lata.2. sa tulong ng isang magnifying glass lamp ay soldered sa PCBA, BGA bahagi upang suriin kung higit sa lahat chips sa punto ng view, ang parallel sa PCBA, kung ang kaukulang ay hindi lumitaw sa paligid ng solder overflow, maikling circuit, atbp, kahit na kung lumitaw sa itaas ang anumang uri ng pangangailangan sa pag-desoldering ng mga bola, hindi kailanman maaaring magmadali sa pag-commissioning ng kuryente, baka palawakin ang saklaw ng kasalanan, Ang kapangyarihan ay maaari lamang i-on upang suriin ang pagganap at pag-andar ng makina kapag ito ay nasuri nang tama.
Proseso ng BGA solder
Para sa paggamit ng mga bahagi ng BGA, maaari kang mag-alala tungkol sa kung ang paghihinang ng mga bahagi ng BGA ay maaaring maging kasing maaasahan ng paggamit ng mas tradisyonal na mga anyo ng kagamitan sa paghihinang. Ang mga component pad ng BGA ay matatagpuan sa ibaba ng device at hindi nakikita. Samakatuwid ito ay kinakailangan upang matiyak na ang proseso ng BGA solder ay ginagamit nang tama.
Sa kabutihang palad, ang teknolohiya ng paghihinang ng BGA ay napatunayang napaka maaasahan. Kapag ang proseso ng BGA solder ay nai-set up nang tama, ang BGA soldering ay karaniwang mas maaasahan kaysa sa quad flat packages. Nangangahulugan ito na ang anumang BGA solder assembly ay mas maaasahan. Bilang resulta, malawak na itong ginagamit para sa mass-produced PCB assemblies at prototype PCB assemblies para sa mga circuit na nasa ilalim ng development.
Para sa proseso ng paghihinang ng BGA, ginagamit ang pamamaraan ng reflow. Ito ay dahil ang buong assembly ay kailangang magpainit sa temperatura kung saan matutunaw ang solder sa ilalim ng BGA assembly. Magagawa lamang ito gamit ang mga diskarte sa reflow.
Para sa paghihinang ng BGA, ang mga bolang panghinang sa pakete ay may napakaingat na kinokontrol na dami ng panghinang. Kapag pinainit sa panahon ng proseso ng paghihinang, matutunaw ang panghinang.
