Ball Grid Array (BGA): De Prozess fir all d'Lötbäll op der Kugelgitter Array vun engem Chip z'ersetzen gëtt BGA Rebound genannt. BGA Packagen si ganz populär ginn an der gedréckter Circuit Board (PCB) Design a Fabrikatioun Industrie. Dës Packagen hëllefen d'Gréisst vun engem PCB ze reduzéieren a seng Funktionalitéit ze verbesseren. BGA kann den Drock vun erofgoen Produit Gréisst widderstoen, a si verlaangen selten Ënnerhalt a Reparatur. Wéi ginn BGA Packagen gefléckt, a wéi eng Schrëtt ginn BGA ëmgeschafft? Dësen Artikel beschreift haaptsächlech de "BGA" IC-Desolde- a BGA-Reballing-Prozess, an d'Saache déi Opmierksamkeet am Reparaturprozess brauchen.

I. D'Saache brauchen Opmierksamkeet am BGA Chip Reparatur Prozess
- Bedreiwer mussen elektrostatesch Braceleten droen.
- Soll de airflow an Drock vun der waarm Loft Pistoul am Viraus ajustéieren virun desoldering BGA
- D'Temperatur vun der waarm Loft Pistoul soll am Viraus gutt agestallt ginn (allgemeng op 280 ~ 320 ℃ kontrolléiert) fir ze verhënneren, datt den Chip duerch exzessiv héich Temperatur am Prozess vun desoldering beschiedegt ginn. Et soll d'Temperatur net erëm ajustéieren während desoldering.
- Wann Dir BGA desolderéiert, beréiert d'BGA sanft mat Pinzette fir ze bestätegen ob d'Löt op der Pad schmëlzt fir ze verhënneren datt de BGA Pad op der Circuit Board beschiedegt gëtt.
- Fir Secondaire Ball soldering ze vermeiden, soll d'Orientatioun markéiert op der PCBA Opmierksamkeet bezuelt ginn wann der BGA Reparatur.
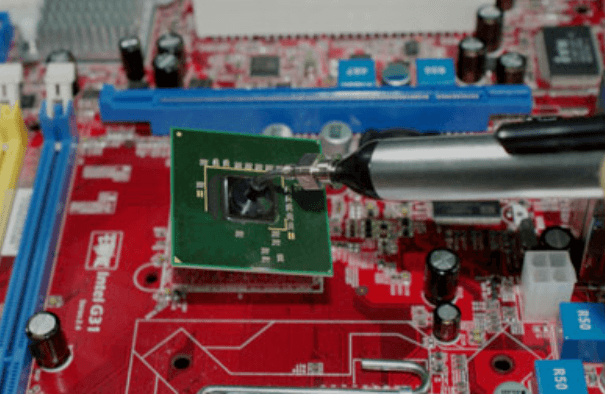
II.Basis Equipement an Handwierksgeschir zu BGA Reparatur benotzt ginn
- Intelligent waarm Loft Pistoul. (fir BGA Desolde)
- Anti-statesch Ënnerhalt Plattform an elektrostatesch Bracelet. (brauchen en elektrostatescht Ëmfeld)
- Anti-statesch Botzen Apparat. (fir BGA Botzen)
- BGA Reparatur Plattform. (fir BGA Solderen)
- Héich Temperatur Këscht (benotzt fir Baken PCBA Board)
- Hëllefsausrüstung: Vakuumsaugstift, Lupe (Mikroskop)

III.Virbereedung vun PCB Verwaltungsrot Baken an Zesummenhang Ufuerderunge virun Reparatur
(1) Geméiss de verschiddene Beliichtungszäiten gëtt de PCBA Board verschidde Bakbedéngungen kritt.
(2) Bakzäit, Baken no de folgende Bestëmmungen:
Beliichtungszäit ≤2 Méint, méi wéi 2 Méint
Bakzäit 10 Stonnen, 20 Stonnen
Baktemperatur 105 ± 5 ℃, 105 ± 5 ℃
(3) Virun der Bakblech, ewechhuelen d'Temperaturempfindlech Komponenten nom Baken, wéi optesch Faser, Plastik, asw .; Soss wäert et dës Komponente beschiedegen wéinst der héijer Temperatur.
(4) Fir all Conseils, muss komplett BGA Reparatur bannent 10 Stonnen nodeems se de Conseils no baacken eraus huelen.
(5) D'PCBA Verwaltungsrot datt BGA Reparatur Aarbecht net komplett kann bannent 10 Stonnen muss an engem drëschenen Uewen fir Erhaalung gesat ginn. Soss ass et einfach ze klebrig zréck ze féieren, a fiicht PCBA ass einfach PCBA Trommel ze verursaachen beim Löt.
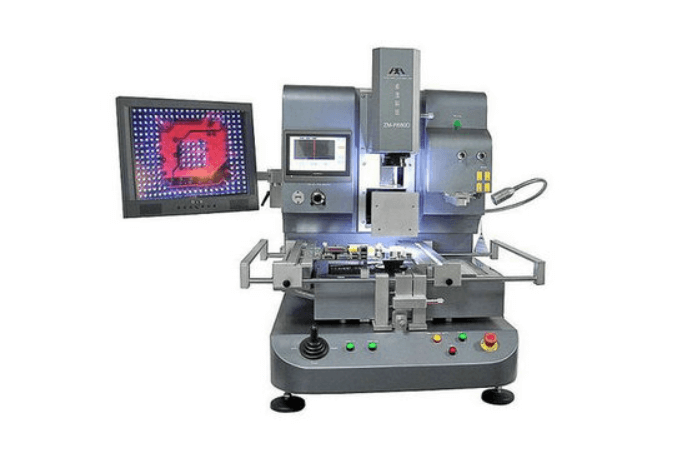
VI. Operatioun Schrëtt vun BGA Chip desoldering an rebelléieren
Virbereedung virun BGA desoldering
De Parameterzoustand vun der Hot Air Pistoul ass wéi follegt gesat: d'Temperatur ass 280 ℃ ~ 320 ℃; desoldering Zäit: 35-55 Sekonnen; Airflow Parameteren: 6 Niveauen; Endlech gëtt de PCBA op der antistatescher Ënnerhaltplattform plazéiert a fixéiert.
BGA desoldering
Bedenkt datt d'Orientéierung an d'Positioun vum Chip virum Entsoldéierung, sou wéi kee Seidbild op PCBA, mat engem Markéierstift zesumme mat der ganzer Zeechnung, oder nieft dem klenge Flux um Enn vun der BGA injizéieren, wielt déi passend Gréisst vu BGA , BGA soldering nozzle ass op der waarm Loft Pistoul installéiert, wäert de vertikalen Ausriichtung BGA verschaffen, mee oppassen op d'nozzle muss Komponente verloossen ca. 4 mm, start d'Hëtzt Pistoul, D'waarm Loft Pistoul gëtt automatesch desolder no de preset Parameteren. Nom Enn vun der Desolder, huelt d'BGA Komponente mat engem Saugstift 2 Sekonnen méi spéit. Nodeems Dir d'Apparater ofgebaut hutt, kontrolléiert ob d'Lötpads vun den demontéierten Maschinnen offalen an ob d'Spure geschrauft, ofgeschleeft oder beschiedegt sinn, asw.
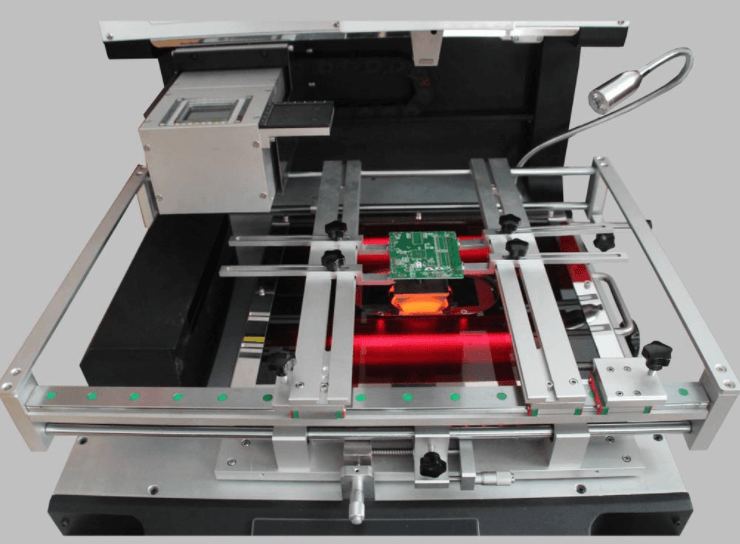
BGA an PCB Botzen
(1) Plaz de Verwaltungsrot op der Aarbecht Dësch a benotzen soldering Eisen absorbéieren iwwerflësseg Reschter aus der Pad, flaach Pad, Botzen wann plazéiert Zinn Absorptioun Linn an solder Pad, eng Hand d'Saug tin Linn ze hiewen, Eisen Absorptioun tin Linn setzen, Hand sanft Press Eisen, Reschtoffall PCBA oder op BGA solder Schmelzen an adsorption Zinn Linn ze absorbéieren, Zinn Absorptioun Linn op déi aner Plaz geplënnert ginn, Fir de Rescht vun der solder absorbéieren, Note: Kraaft net op der solder Pad ze zéien , fir Schued un der solder Pad ze vermeiden.
(2) Nodeems Dir d'Pads botzt, benotzt d'Wäschwaasser fir d'PCBA Pads ze botzen. Wann d'virtuell soldering CPU muss de Ball replantéieren, benotzt den Ultraschallreiniger (mat engem antistateschen Apparat) fir d'Wäschwaasser ze lueden, an d'geläscht BGA gëtt gebotzt an de Ball fir d'Lötung erstallt.
Bemierkung: Fir d'Löter Pad Botzen vun Bläi-gratis Apparater, ass d'Temperatur vun der soldering Eisen néideg < gemooss Wäert> 340 +/-40 ℃; Fir d'Botzen vun CBGA an CCGA Pads, ass d'Temperatur vun der soldering Eisen néideg < gemooss Wäert> 370 +/-30 ℃; et gi spezifesch Differenzen an all soldering Eisen (wéi niddreg soldering Temperatur), w.e.g. virstellen, an déi Responsabel wäert Upassungen no der aktueller Situatioun maachen. Wann keng Upassung gemaach gëtt, muss strikt déi uewe genannte Viraussetzungen ëmsetzen.
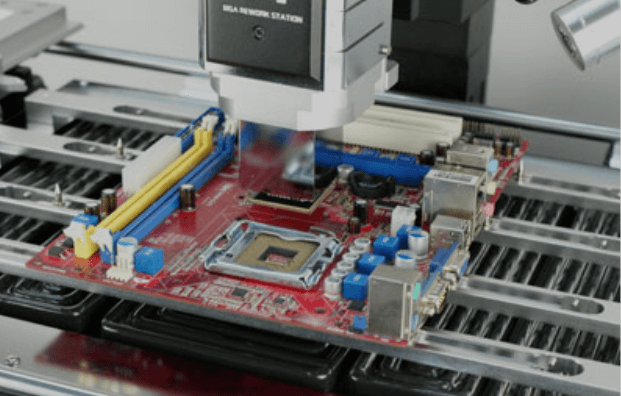
BGA Chip reballing
D'Zinn Planzung vum BGA-Chip soll aus Laser-Punche Schabloun mat Single-Side Horn Mesh gemaach ginn. D'Schabloundicke soll 2 mm déck sinn, an d'Lachmauer soll glat an uerdentlech sinn. Den ënneschten Deel vum Horn Lach (d'Gesiicht dat de BGA kontaktéiert) soll 10μm ~ 15μm méi grouss sinn wéi d'Spëtzt (d'Zinn an d'Plaz schrauwen). Benotzt d'Zinnplantatiounsfunktioun an der BGA Ënnerhaltstabell hei uewen - Fixture a Schabloun, fann fir d'éischt déi entspriechend konkave Positioun an der Positionéierungsarmatur, fixéiert de BGA an der Positionéierungsarmatur, setzt d'Schabloun mat präzis Positionéierungsquadrateschen a ronnen Lächer op der Positionéierungsarmatur, an dann dréckt d'Schabloun op der Armature mat sengem Accessoire Magnéitpressblock. D'Tool huet dräi Präzisiounspositionéierungsgeräter (BGA → Fixture → Schabloun), déi d'Schabloun Mesh einfach a präzis mat der klenger Lötpad vun der BGA Komponent ausriichten.
E klenge Schrack ass eng kleng Quantitéit vun décke Blechschläim, déi op d'Schabloun Mesh geschrauft gëtt. Wann all Mesh gemaach ass voll, vun engem Enn vun der Schabloun wäert lues opgehuewe ginn, BGA Chip, eng kleng Zinn Koup, erëm mat enger waarm Loft Pistoul et ze Hëtzt, der BGA Zinn Koup an eng eenheetlech Array vun der Zinn Ball kann ginn. Wann et keng Blechkugel an eenzel Pads ass, kann eng Schabloun erëm gedréckt ginn fir lokal Blechfüllung. Et kann net zesumme mat der Schabloun erhëtzt ginn, well et Reballing beaflosst a wäert déi präzis Schabloun thermesch Deformatioun a Schued sinn.
BGA Chip soldering
Daucht eng kleng Quantitéit vun dichten Flux op der BGA Zinn Bäll an PCBA pads, recuperéieren der original Mark a Plaz der BGA. D'BGA soll gekollt a positionéiert ginn, fir ze verhënneren, datt et duerch waarme Wand geplatzt gëtt. Wéi och ëmmer, et sollt bemierkt datt zevill Flux net sollt gesat ginn. Soss wäerten exzessive Bubbles vu Rosin den Chip bei der Heizung verschwannen. PCBA Verwaltungsrot ass och op der BGA rework Plattform fix a muss Niveau plazéiert ginn, änneren der gëeegent nozzle, nozzle op der BGA Chip a lénks 4 mm, wielt BGA zu Rework Statiounen Primärschoul Formatioun Temperatur Curve, klickt op Écran vun automatesch soldering (Note). : wäert net Drock op BGA soldering Prozess gëllen, einfach eng kuerz Circuit tëscht Zinn Ball ënner dem verursaache.)
Mat der Schmelz vun der BGA Zinnkugel an der Bildung vum PCBA-Lötpad-Lötung, an duerch d'Uewerflächespannung vum Zinnkugel, gëtt den Chip automatesch zentréiert och wann et eng Ofwäichung vum Motherboard ass. Wann de BGA Reparatur Dësch erhëtzt ass, gëtt d'BGA soldering Operatioun zu dëser Zäit ofgeschloss. Wéi och ëmmer, et sollt bemierkt datt de BGA Reparaturdësch en Alarmklang no der Heizung mécht. Zu dëser Zäit, plënneren net der BGA Reparatur Dësch an PCBA Verwaltungsrot, well d'BGA Reparatur Dësch an PCBA Verwaltungsrot an enger héich Temperatur an unsolidified Staat sinn. Et muss wait fir 40 Sekonnen virun der BGA Reparatur Dësch, an PCBA killt.
Inspektioun vun BGA soldering an Botzen vun PCBA Verwaltungsrot
1. No der Réalisatioun vun soldering, BGA Komponente an PCBA soll vun wäschen Platen Waasser gebotzt ginn iwwerschësseg Flux a méiglech Zinn scraps ze läschen.2. mat der Hëllef vun enger Lupe Luucht gouf soldered op PCBA, BGA Komponent ze kontrolléieren ob haaptsächlech Chips op der Siicht, d'Parallel mat PCBA, ob déi entspriechend net um solder iwwerflësseg wossten, kuerz Circuit, etc. wann erschéngen uewen all Zort vun brauchen Bäll ze desoldering, kann ni séier Elektrizitéit Kommissioun, net den Ëmfang vun der Schold expandéieren, D'Kraaft kann nëmmen ageschalt ginn der Leeschtung an Funktioun vun der Maschinn ze kontrolléieren wann et richteg iwwerpréift ass.
BGA solder Prozess
Fir BGA Komponenten ze benotzen, kënnt Dir besuergt sinn ob soldering BGA Komponente sou zouverlässeg kënne sinn wéi méi traditionell Forme vu Lötausrüstung ze benotzen. BGA Komponente Pads sinn ënnert dem Apparat etabléiert a sinn net siichtbar. Dofir ass et néideg ze garantéieren datt de BGA-Lötprozess richteg benotzt gëtt.
Glécklecherweis huet BGA soldering Technologie bewisen ganz zouverlässeg ze sinn. Wann de BGA-Lötprozess richteg ageriicht ass, ass BGA-Lötung allgemeng méi zouverlässeg wéi Quad-Flaach Packagen. Dëst bedeit datt all BGA solder Assemblée méi zouverlässeg ass. Als Resultat ass et elo wäit benotzt fir Mass-produzéiert PCB Versammlungen a Prototyp PCB Versammlungen fir Circuiten ënner Entwécklung.
Fir de BGA-Lötprozess gëtt d'Reflow-Technik benotzt. Dëst ass well d'ganz Versammlung muss op d'Temperatur erwiermt ginn, bei där d'Löt ënner der BGA-Versammlung schmëlzt. Dëst kann nëmme mat Reflow Techniken erreecht ginn.
Fir BGA soldering, der solder Bäll op der Pak hunn eng ganz suergfälteg kontrolléiert haten Quantitéit vun solder. Wann et während dem Lötprozess erhëtzt gëtt, schmëlzt d'Löt.
