볼 그리드 어레이(BGA): 칩의 볼 그리드 어레이에서 모든 솔더 볼을 교체하는 프로세스를 BGA 리바운드라고 합니다. BGA 패키지는 인쇄 회로 기판(PCB) 설계 및 제조 산업에서 매우 인기가 있습니다. 이 패키지는 PCB의 크기를 줄이고 기능을 향상시키는 데 도움이 됩니다. BGA는 제품 크기 감소의 압력을 견딜 수 있으며 유지 보수 및 수리가 거의 필요하지 않습니다. BGA 패키지는 어떻게 수리되며 BGA 재작업 단계는 무엇입니까? 이 기사는 주로 "BGA" IC 디솔더링 및 BGA 리볼링 프로세스와 수리 프로세스에서 주의가 필요한 사항에 대해 설명합니다.

I. BGA Chip Repair 공정에서 주의가 필요한 사항
- 작업자는 정전기 팔찌를 착용해야 합니다.
- BGA를 제거하기 전에 열풍총의 공기 흐름과 압력을 미리 조정해야 합니다.
- 열풍총의 온도는 디솔더링 과정에서 과도한 고온에 의해 칩이 손상되는 것을 방지하기 위해 미리 잘 설정(보통 280~320℃로 제어)해야 합니다. 납땜 제거 중에 다시 온도를 조정해서는 안됩니다.
- BGA 디솔더링 시 핀셋으로 BGA를 살살 만져 패드 위의 솔더가 녹는지 확인하여 회로기판 위의 BGA 패드가 손상되는 것을 방지한다.
- XNUMX차 볼 솔더링을 방지하려면 BGA를 수리할 때 PCBA에 표시된 방향에 주의해야 합니다.
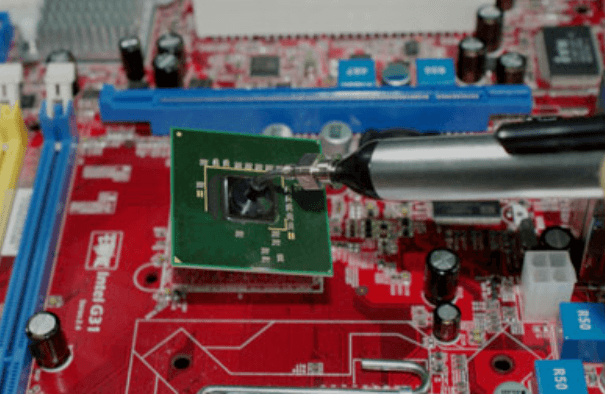
II.BGA 수리에 사용되는 기본 장비 및 도구
- 지능형 뜨거운 공기총. (BGA 디솔더링용)
- 정전기 방지 유지 보수 플랫폼 및 정전기 팔찌. (정전기 환경 필요)
- 정전기 방지 청소 장치. (BGA 세정용)
- BGA 수리 플랫폼. (BGA 솔더링용)
- 고온 박스(PCBA 보드 베이킹에 사용)
- 보조 장비: 진공 흡입 펜, 확대경(현미경)

III. 수리 전 PCB 보드 베이킹 및 관련 요구 사항 준비
(1) 다른 노출 시간에 따라 PCBA 보드에 다른 베이킹 요구 사항이 부여됩니다.
(2) 베이킹 시간, 다음 규정에 따라 베이킹:
노출 시간 ≤2개월, 2개월 이상
굽는 시간 10시간, 20시간
베이킹 온도 105±5℃, 105±5℃
(3) 베이킹 보드 앞에서 광섬유, 플라스틱 등과 같은 베이킹 후 온도에 민감한 구성 요소를 제거하십시오. 그렇지 않으면 고온으로 인해 이러한 구성 요소가 손상됩니다.
(4) 모든 기판은 베이킹 후 기판을 꺼낸 후 10시간 이내에 BGA 수리를 완료해야 합니다.
(5) 10시간 이내에 BGA 수리 작업을 완료하지 못한 PCBA 기판은 건조 오븐에 넣어 보존해야 합니다. 그렇지 않으면 접착력이 떨어지기 쉽고 축축한 PCBA는 납땜시 PCBA 드럼을 일으키기 쉽습니다.
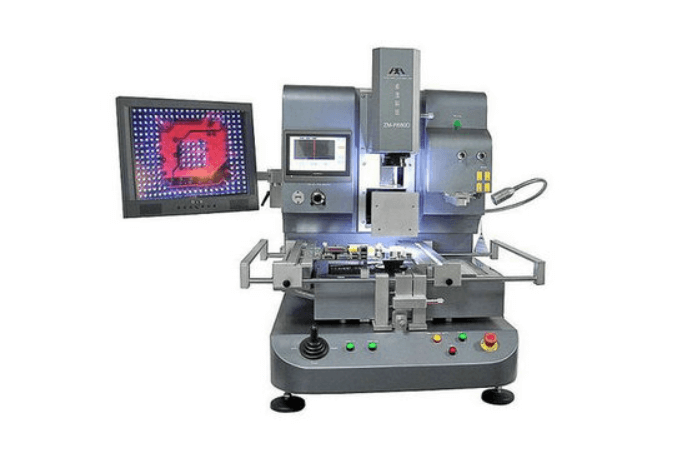
VI. BGA 칩 디솔더링 및 반란의 작동 단계
BGA 디솔더링 전 준비
열풍총의 매개변수 상태는 다음과 같이 설정됩니다: 온도는 280℃~320℃입니다. 납땜 제거 시간: 35-55초; 기류 매개변수: 6개 수준; 마지막으로 PCBA를 정전기 방지 유지 보수 플랫폼에 놓고 고정합니다.
BGA 디솔더링
PCBA에 실크스크린이 없거나, 마커 펜을 사용하거나, BGA 하단에 작은 플럭스를 주입하기 전에 BGA의 적절한 크기를 선택하는 것과 같이 디솔더링 전 칩의 방향과 위치를 염두에 두십시오. , BGA 솔더링 노즐은 핫 에어 건에 설치되며 수직 정렬 BGA를 처리하지만 노즐에 주의해야 할 구성 요소는 ca. 4mm, 히트 건을 시작하면 핫 에어 건이 미리 설정된 매개 변수에 따라 자동으로 납땜 제거됩니다. 디솔더 종료 후 2초 후 석션펜으로 BGA 부품을 제거합니다. 장치를 분해한 후, 분해된 기계의 솔더 패드가 떨어지는지, 흔적이 긁히거나 벗겨지거나 손상되는지 등을 확인하십시오. 비정상적인 피드백과 제때 처리를 제공합니다.
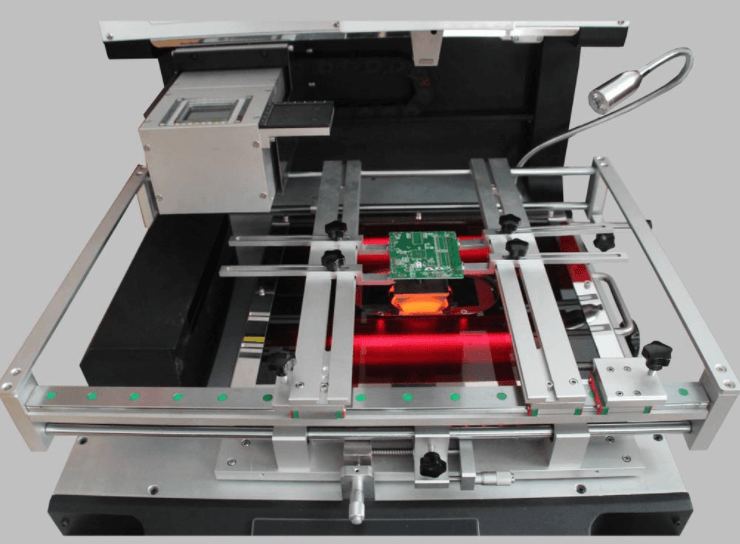
BGA 및 PCB 청소
(1) 보드를 작업대에 놓고 납땜 인두를 사용하여 패드, 플랫 패드에서 중복 잔류물을 흡수하고 솔더 패드에 주석 흡수 라인을 배치할 때 청소하고 한 손으로 흡입 주석 라인을 들어 올리고 철 흡수 주석 라인을 놓고, 손으로 부드럽게 눌러 철, 잔류 납땜 PCBA 또는 BGA 납땜 용융 및 흡착을 흡수하여 주석 라인, 주석 흡수 라인을 다른 위치로 이동, 나머지 납땜을 흡수하려면 참고: 납땜 패드에 힘을 주어 끌지 마십시오. , 솔더 패드의 손상을 방지합니다.
(2) 패드 세척 후 세척수를 사용하여 PCBA 패드를 세척하십시오. 가상 솔더링 CPU가 볼을 이식해야 하는 경우 초음파 세척기(정전기 방지 장치 포함)를 사용하여 세척수를 로드하고 제거된 BGA를 세척하고 볼을 다시 이식하여 납땜합니다.
참고: 무연 장치의 납땜 패드 세척을 위해 납땜 인두의 온도는 < 측정값 >340+/-40℃가 되어야 합니다. CBGA 및 CCGA 패드의 세척을 위해 납땜 인두의 온도는 <측정값>370+/-30℃가 되어야 합니다. 각 납땜 인두에는 특정 차이가 있습니다(예: 낮은 납땜 온도). 담당자가 실제 상황에 따라 조정합니다. 조정하지 않은 경우 위의 요구 사항을 엄격히 이행해야 합니다.
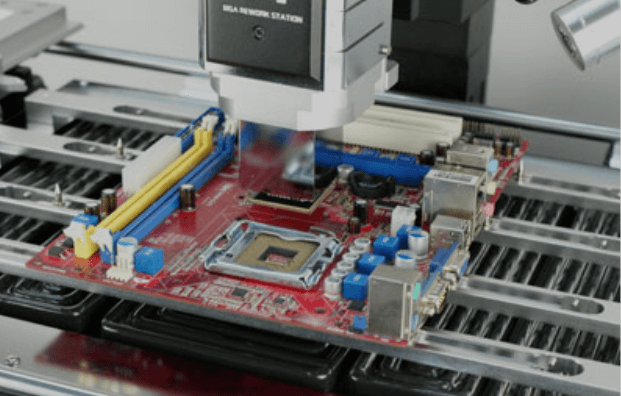
BGA 칩 리볼링
BGA 칩의 주석 심기는 단면 혼 메시가 있는 레이저 천공 스텐실로 만들어야 합니다. 스텐실 두께는 2mm이고 구멍 벽은 매끄럽고 깔끔해야 합니다. 혼 홀의 바닥(BGA와 접촉하는 면)은 상단(주석을 스폿으로 긁어냄)보다 10μm~15μm 더 커야 합니다. 위의 BGA 유지 관리 테이블에서 주석 심기 기능을 사용하여 고정 장치 및 스텐실, 먼저 위치 고정 장치에서 해당 오목한 위치를 찾고 위치 고정 장치에 BGA를 고정하고 정확한 위치 지정 사각형 및 원형 구멍이 있는 스텐실을 위치 지정 고정 장치에 놓고, 그런 다음 액세서리 마그네틱 프레스 블록으로 고정 장치의 스텐실을 누릅니다. 이 도구에는 XNUMX개의 정밀 포지셔닝 장치(BGA→ 고정 장치 → 스텐실)가 있어 스텐실 메시를 BGA 구성 요소의 작은 솔더 패드와 쉽고 정확하게 정렬할 수 있습니다.
작은 스크레이퍼는 스텐실 메쉬에 긁힌 소량의 두꺼운 주석 슬러리입니다. 모든 메시가 가득 찼을 때 스텐실의 한쪽 끝에서 BGA 칩, 작은 주석 더미를 천천히 들어 올리고 뜨거운 공기총으로 다시 열을 가하면 BGA 주석 더미가 주석 볼의 균일한 배열로 들어갈 수 있습니다. BE. 개별 패드에 주석 볼이 없으면 로컬 주석 충전을 위해 스텐실을 다시 누를 수 있습니다. 그것은 reballing에 영향을 미치고 정밀한 스텐실 열 변형 및 손상이 되기 때문에 스텐실과 함께 가열될 수 없습니다.
BGA 칩 솔더링
소량의 조밀한 플럭스를 BGA 주석 볼과 PCBA 패드에 담그고 원래 표시를 검색하고 BGA를 배치합니다. BGA는 접착되어 뜨거운 바람에 날아가지 않도록 배치해야 합니다. 그러나 플럭스를 너무 많이 넣지 않도록 주의해야 합니다. 그렇지 않으면 로진의 과도한 기포로 인해 가열 시 칩이 이동합니다. PCBA 보드는 또한 BGA 재작업 플랫폼에 고정되어 있어야 하며 수평으로 배치해야 합니다. 적절한 노즐을 변경하고 BGA 칩의 노즐을 4mm 남겨두고 BGA를 재작업 스테이션 기본 설정 온도 곡선으로 선택하고 자동 납땜 화면을 클릭합니다(참고 : BGA 솔더링 공정에 압력을 가하지 않아 아래 주석 볼 사이에 단락이 발생하기 쉽습니다.)
BGA 주석 볼이 녹고 PCBA 솔더 패드 솔더링이 형성되고 주석 볼의 표면 장력을 통해 마더보드에서 편차가 있어도 칩이 자동으로 중앙에 위치합니다. BGA 리페어 테이블이 가열되면 이때 BGA 솔더링 작업이 완료됩니다. 그러나 BGA 수리 테이블은 가열 후 알람 소리를 낼 것입니다. 이때 BGA repair table과 PCBA board는 고온의 미응고 상태이므로 BGA repair table과 PCBA board를 이동하지 마십시오. BGA 수리 테이블과 PCBA가 냉각되기 전에 40초 동안 기다려야 합니다.
BGA 솔더링 검사 및 PCBA 기판 세척
1. 솔더링 완료 후, BGA 구성 요소와 PCBA는 과도한 플럭스 및 가능한 주석 스크랩을 제거하기 위해 플레이트 워터를 세척하여 세척해야 합니다.2. 돋보기 램프의 도움으로 PCBA, BGA 구성 요소에 납땜되어 주로 칩이 관점에 있는지, PCBA와 병렬인지, 솔더 오버플로, 단락 등 주변에 해당이 나타나지 않았는지 여부를 확인합니다. 볼을 납땜 제거해야 할 필요가 있는 경우 절대 급하게 전기 시운전을 할 수 없습니다. 결함의 범위를 확장하지 않도록 전원을 켜서 올바르게 점검된 경우 기계의 성능과 기능을 확인하기 위해서만 켜질 수 있습니다.
BGA 솔더 공정
BGA 구성 요소를 사용하는 경우 BGA 구성 요소 납땜이 보다 전통적인 형태의 납땜 장비를 사용하는 것만큼 신뢰할 수 있는지에 대해 걱정할 수 있습니다. BGA 구성 요소 패드는 장치 아래에 있으며 보이지 않습니다. 따라서 BGA 솔더 공정이 올바르게 사용되었는지 확인하는 것이 필요합니다.
다행스럽게도 BGA 솔더링 기술은 매우 신뢰할 수 있는 것으로 입증되었습니다. BGA 솔더 공정이 올바르게 설정되면 BGA 솔더링은 일반적으로 쿼드 플랫 패키지보다 더 안정적입니다. 이것은 모든 BGA 솔더 어셈블리가 더 안정적이라는 것을 의미합니다. 그 결과 현재는 양산 PCB 어셈블리와 개발 중인 회로용 프로토타입 PCB 어셈블리에 널리 사용되고 있습니다.
BGA 솔더링 공정에는 리플로우 기술이 사용됩니다. BGA 어셈블리 아래에서 솔더가 녹는 온도까지 전체 어셈블리를 예열해야 하기 때문입니다. 이는 리플로우 기술을 통해서만 달성할 수 있습니다.
BGA 솔더링의 경우 패키지의 솔더 볼에는 솔더 양이 매우 신중하게 제어됩니다. 납땜 공정 중에 가열하면 땜납이 녹습니다.
